
《表面组装技术》
实 训 报 告
指导老师: 梁颖 、朱静
姓 名: 张 强
班 级: 212361
学 号: 121802
航空电子工程系
20##年5月
目录
一、实训目的
二、实训内容
三、焊膏印刷
四、贴片
五、焊接
六、检测(缺陷分析)
七、返修
八、总结
九、附录(工艺文件)
一、实训目的
1.通过SMT实训,熟悉常用电子元器件的识别、检测;
2.对SMT生产工艺流程的一个认识;
3.学会应用SMT设备来完成这周实训的内容;
4.掌握重要设备的使用方法,培养工作能力;
5.学会处理实训中可能遇到的问题以及缺陷的分析。
二、实训内容
表面组装技术(SMT)是由混合集成电路技术发展而来的新一代电子装联技术,以采
用元器件表面贴装技术和回流焊接技术为特点,成为电子产品制造中新一代的组装技术。
SMT生产线主要设备有: 印刷机、贴片机(上表面电子元件)、回流焊、插件、波峰炉、
测试包装。SMT的广泛应用,促进了电子产品的小型化、多功能化,为大批量生产、低
缺陷率生产提供了条件。本周实训使用流水灯练习板来进行一些设备的熟悉,下面是一个回流焊技术生产产品的一般工艺流程图:

三、焊膏印刷
随着表面贴装技术的快速发展,在其生产过程中,焊膏印刷对于整个生产过程的影响和作用越来越受到生产工艺师和工艺工程师们的重视,焊膏印刷技术是采用已经制好的网板,用一定的方法使丝网和印刷机直接接触,并使焊膏在网板上均匀流动,由掩模图形注入网孔。当丝网拖开印制板时,焊膏就以掩模图形的形状从网孔脱落到印制板相应的焊盘图形上,从而完成了焊膏在印制板上的印刷,如图所示。完成这个印刷过程而采用的设备就是丝网印刷机。焊膏印刷是SMT生产过程中最关键的工序之一,印刷质量的好坏将直接影响SMD组装的质量和效率,据统计60%-70%的焊接缺陷都是由不良的焊膏印刷结果所造成,因而要提高焊膏印刷质量,尽可能将印刷缺陷降低到最低,要实现高质量的重复印刷,焊膏的特性、网板的制作、印刷工艺参数的设置都十分关键。




四、贴片
贴片就是将SMC/SMD等表面贴装元器件从其包装结构中取出,然后贴放到PCB的指定焊盘位置上。当然,所贴放的焊盘位置需是已涂覆了锡膏,或虽未涂覆锡膏,但在元器件所覆盖的PCB上已涂覆了贴片胶。贴放后,元器件依靠锡膏或贴片胶的黏附力黏在指定的焊盘位置上。
早期,由于片式元器件尺寸相对较大,人们用镊子等简单的工具就可以实现上述动作,至今仍有少数小规模工厂采用或部分采用人工放置元件的方法。但为了满足大批生产的需要,特别是随着无源元件像微型化,有源器件向多引脚、细间距方向的不断发展,元器件类型越来越多,尺寸或引脚间距越来越小,因此贴片工作已经越来越依赖于高精度的贴片机设备来实现。贴片机的定位精度、贴片速度及可贴装的元器件种类已经成为衡量贴片机性能的三项重要指标。

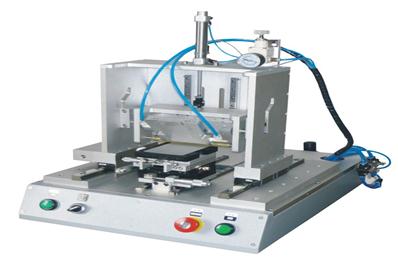

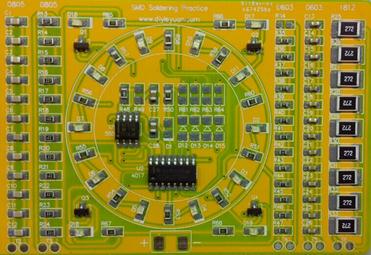
五、焊接
再流焊又称“回流焊”,是伴随微型化电子产品的出现而发展起来的焊接技术,主要用于各类表面组装元器件的焊接。它提供一种加热环境,使预先分配到印制板焊盘上的膏状软钎焊料重新熔化,从而让表面贴装的元器件和PCB焊盘通过焊锡膏合金可靠地结合在一起。再流焊操作方法简单,效率高,质量和一致性好,节省焊料,是一种适用于自动化生产的电子产品装配技术,目前已经成为SMT的电路板组装技术的主流。
再流焊使用的焊料是焊锡膏。预先在电路板的焊盘上涂上适量和适当形式的焊锡膏,再把SMT元器件贴放到相应的位置;焊锡膏具有一定的黏性,使元器件固定;然后让贴装好元器件的电路板进入再流焊设备实施再流焊,通过外部热源加热,使焊料熔化而再次流动浸润,将元器件焊接到印制板上。



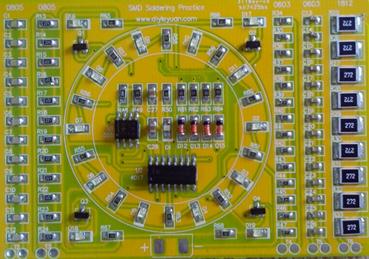
六、检测(缺陷分析)
PCB组件是现代电子产品中相当重要的一个组成部分,PCB的布线和设计随着电子产品向快速、小型化、轻量化方向迈进的步伐。随着SMT的发展和SMA组装密度的提高,以及电路图形的细线化,SMD的细间距化,器件引脚的不可视化等特征的增强,PCB组件的可靠性和高质量将直接关系到该电子产品是否具有高可靠性和高质量,为此,采用先进的SMT检测技术对PCB组件进行检测,可以将有关问题消除在萌芽状态。


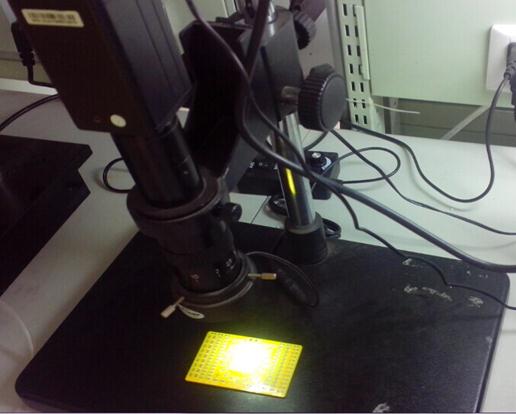
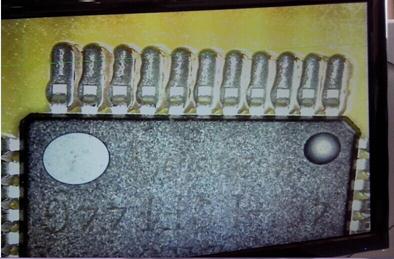
缺陷分析:
1. 桥连
又称桥接,指元件端头之间、元器件相邻的焊点之间以及焊点与邻近的导线、过孔等电气上不该连接的部位被焊锡连接在一起。桥连经常出现在细间距元器件引脚间或间距较小的片式组件间,桥连的产生会严重影响产品的性能。

桥连
2 .立碑
立碑是指两个焊端的表面组装元件,经过再流焊后其中一个端头离开焊盘表面,整个元件呈斜立或直立,如石碑状,又称吊桥、曼哈顿现象。如图所示,该矩形片式组件的一端焊接在焊盘上,而另一端则翘立。
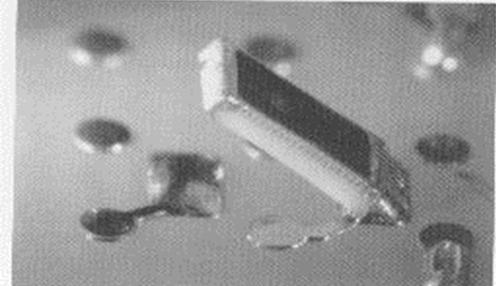
立碑
3.锡珠
锡珠是再流焊中经常碰到的焊接缺陷,多发生在焊接过程中的急速加热过程中;或预热区温度过低,突然进入焊接区,也容易产生锡珠。
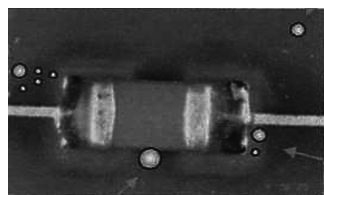
锡珠
4.元件偏移
元件偏移的情况如图所示,观察缺陷的发生时间,可分为两种情况加以分析:
① 再流焊接前元件偏移。先观察焊接前基板上组装元件位置是否偏移,如果有这种情况,可检查一下焊膏粘接力是否合乎要求。如果不是焊膏的原因,再检查贴装机贴装精度、位置是否发生了偏移。贴装机贴装精度不够或位置发生了偏移、焊膏粘接力不够,导致元件偏移。
② 再流焊接时元件偏移。虽然焊料的润湿性良好,有足够的自调整效果,但最终发生了元件的偏移,这时要考虑再流焊炉内传送带上是否有振动等影响,对再流焊炉进行检验。如不是这个原因,则可从元件曼哈顿不良因素加以考虑,是否是两侧焊区的一侧焊料熔融快,由熔融时的表面张力发生了元件的错位。

元件偏移
七、返修
SMA的返修,通常是为了去除失去功能、引线损坏或排列错误的元器件,重新更换新的元器件。或者说,就是使不合格的电路组件恢复与特定要求相一致的合格的电路组件。为了满足电子设备更小、更轻和更便宜的要求,对返修工艺的要求也在提高。
对于上述回流焊接的缺陷,我们进行了返修,主要过程分为:拆焊—器件整形-PCB焊盘清理-贴放器件-焊盘焊接。最后,我们完成了整个SMT生产的一个流程,并成功实现了本周实训LED流水灯印制板图。
八、总结
经过一周的SMT的实训,我还是了解了不少,且感触颇深。刚开始的时候,想想觉得理论学起来还觉得轻松,但实际操作觉得对于SMT是真的不怎么了解,且认为它是一种新型技术。在实训时,经过老师的讲解,以及我们之前在理论课上对它的了解,才知道SMT在几乎所有的电子产品生产中都得到了广泛的应用。说实话,一开始就要我们对于这项技术的各个环节,各个部分都弄得很透,我想那是不现实的,因为这其中还有很多细节的地方,或者需要深入研究的地方,这都不是一周的时间里所能够完成的。
在对SMT生产线观摩的过程中,我有看到,它们的每一道工序,以及每一道流程具体的是什么样的,看得出来在这样的环境下工作,是需要细心、耐心、专心的,还有的工作岗位时需要有一定的技术能力以及相关知识的。此外,这次实训,我觉得老师不仅仅是在教我们怎样了解此专业,另一方面,老师也教会了我们一些职业素养,对于即将走上职业岗位的我们来说,这点是非常重要的。老师的那些话我还记得,SMT的第一步是什么呢?做完这一步接下来又该做什么呢?最后该做什么呢......一连串的问题。 总之,我觉得实训是对理论知识复习的一方面,另一方面是教会我们做人做事,怎样在其位谋好其职,也是另外一个很重要的方面,此次的实训受益匪浅。
九、附录(工艺文件)
第二篇:SMT表面组装技术

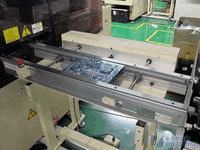

SMT机器
SMT是表面组装技术(表面贴装技术)(Surface Mounted Technology的缩写),是目前电子组装行业里最流行的一种技术和工艺。
SMT有何特点
组装密度高、电子产品体积小、重量轻,贴片元件的体积和重量只有传统插装元件的1/10左右,一般采用SMT之后,电子产品体积缩小40%~60%,重量减轻60%~80%。
SMT
可靠性高、抗振能力强。焊点缺陷率低。
高频特性好。减少了电磁和射频干扰。
易于实现自动化,提高生产效率。降低成本达30%~50%。 节省材料、能源、设备、人力、时间等。
为什么要用SMT
电子产品追求小型化,以前使用的穿孔插件元件已无法缩小。
电子产品功能更完整,所采用的集成电路(IC)已无穿孔元件,特别是大规模、高集成IC,不得不采用表面贴片元件。
产品批量化,生产自动化,厂方要以低成本高产量,出产优质产品以迎合顾客需求及加强市场竞争力
电子元件的发展,集成电路(IC)的开发,半导体材料的多元应用。 电子科技革命势在必行,追逐国际潮流。
SMT 基本工艺构成要素

印刷(或点胶)--> 贴装 --> (固化) --> 回流焊接 --> 清洗 --> 检测 --> 返修
印刷
其作用是将焊膏或贴片胶漏印到PCB的焊盘上,为元器件的焊接做准备。所用设备为印刷机
SMT加工车间
(锡膏印刷机),位于SMT生产线的最前端。
点胶
因现在所用的电路板大多是双面贴片,为防止二次回炉时投入面的元件因锡膏再次熔化而脱落,故在投入面加装点胶机,它是将胶水滴到PCB的固定位置上,其主要作用是将元器件固定到PCB板上。所用设备为点胶机,位于SMT生产线的最前端或检测设备的后面。有时由于客户要求产出面也需要点胶, 而现在很多小工厂都不用点胶机,若投入面元件较大时用人工点胶。 贴装
其作用是将表面组装元器件准确安装到PCB的固定位置上。所用设备为贴片机,位于SMT生产线中印刷机的后面。
固化
其作用是将贴片胶融化,从而使表面组装元器件与PCB板牢固粘接在一起。所用设备为固化炉,位于SMT生产线中贴片机的后面。
回流焊接
其作用是将焊膏融化,使表面组装元器件与PCB板牢固粘接在一起。所用设备为回流焊炉,位于SMT生产线中贴片机的后面。
清洗
其作用是将组装好的PCB板上面的对人体有害的焊接残留物如助焊剂等除去。所用设备为清洗机,位置可以不固定,可以在线,也可不在线。
检测
其作用是对组装好的PCB板进行焊接质量和装配质量的检测。所用设备有放大镜、显微镜、在线测试仪(ICT)、飞针测试仪、自动光学检测(AOI)、X-RAY检测系统、功能测试仪等。位置根据检测的需要,可以配置在生产线合适的地方。
返修
其作用是对检测出现故障的PCB板进行返工。所用工具为烙铁、返修工作站等。配置在生产线中任意位置。
SMT常用知识简介
1.一般来说,SMT车间规定的温度为25±3℃。
2.锡膏印刷时,所需准备的材料及工具锡膏、钢板、刮刀、擦拭纸、无尘纸、清洗剂、搅拌刀。
3. 一般常用的锡膏合金成份为Sn/Pb合金,且合金比例为63/37。
4. 锡膏中主要成份分为两大部分锡粉和助焊剂。
5. 助焊剂在焊接中的主要作用是去除氧化物、破坏融锡表面张力、防止再度氧化。
6. 锡膏中锡粉颗粒与Flux(助焊剂)的体积之比约为1:1, 重量之比约为9:1。
7. 锡膏的取用原则是先进先出。
8. 锡膏在开封使用时,须经过两个重要的过程回温、搅拌。
9. 钢板常见的制作方法为:蚀刻、激光、电铸。
10. SMT的全称是Surface mount(或mounting)technology,中文意思为表面粘着(或贴装)技术。
11. ESD的全称是Electro-static discharge, 中文意思为静电放电。
12. 制作SMT设备程序时, 程序中包括五大部分, 此五部分为PCB data; Mark data;Feeder data; Nozzle data; Part data。
13. 无铅焊锡Sn/Ag/Cu 96.5/3.0/0.5的熔点为 217C。
14. 零件干燥箱的管制相对温湿度为 < 10%。
15. 常用的被动元器件(PassiveDevices)有:电阻、电容、点感(或二极体)等;主动元器件(ActiveDevices)有:电晶体、IC等。
16. 常用的SMT钢板的材质为不锈钢。
17. 常用的SMT钢板的厚度为0.15mm(或0.12mm)。
18.静电电荷产生的种类有摩擦、分离、感应、静电传导等;静电电荷对电子工业的影响为:ESD失效、静电污染;静电消除的三种原理为静电中和、接地、屏蔽。
19. 英制尺寸长x宽0603=0.06inch*0.03inch,公制尺寸长x宽3216=3.2mm*1.6mm。
20. 排阻ERB-05604-J81第8码“4”表示为4个回路,阻值为56欧姆。电容ECA-0105Y-M31容值为C=106PF=1NF =1X10-6F。
21. ECN中文全称为:工程变更通知单;SWR中文全称为:特殊需求工作单,必须由各相关部门会签,文件中心分发, 方为有效。
22. 5S的具体内容为整理、整顿、清扫、清洁、素养。
23. PCB真空包装的目的是防尘及防潮。
24. 品质政策为:全面品管、贯彻制度、提供客户需求的品质;全员参与、及时处理、以达成零缺点的目标。
25. 品质三不政策为:不接受不良品、不制造不良品、不流出不良品。
26. QC七大手法中鱼骨查原因中4M1E分别是指(中文): 人力Man、物料Material、机器Machine、方法Method、环境Environment。
27.锡膏的成份包含:金属粉末、溶济、助焊剂、抗垂流剂、活性剂;按重量分,金属粉末占85-92%,按体积分金属粉末占50%;其中金属粉末主要成份为锡和铅,比例为63/37,熔点为183℃。
28. 锡膏使用时必须从冰箱中取出回温,目的是:让冷藏的锡膏温度回复常温,以利印刷。如果不回温则在PCBA进Reflow后易产生的不良为锡珠。
29. 机器之文件供给模式有:准备模式、优先交换模式、交换模式和速接模式。
30. SMT的PCB定位方式有:真空定位、机械孔定位、双边夹定位及板边定位。
31. 丝印(符号)为272的电阻,阻值为 2700Ω,阻值为4.8MΩ的电阻的符号(丝印)为485。
32. BGA本体上的丝印包含厂商、厂商料号、规格和Datecode/(Lot No)等信息。
33. 208pinQFP的pitch为0.5mm。
34. QC七大手法中, 鱼骨图强调寻找因果关系;
35. CPK指: 目前实际状况下的制程能力;
36. 助焊剂在恒温区开始挥发进行化学清洗动作;
37. 理想的冷却区曲线和回流区曲线镜像关系;
38. Sn62Pb36Ag2之焊锡膏主要试用于陶瓷板;
39. 以松香为主的助焊剂可分四种: R、RA、RSA、RMA;
40. RSS曲线为升温→恒温→回流→冷却曲线;
41. 我们现使用的PCB材质为FR-4;
42. PCB翘曲规格不超过其对角线的0.7%;
43. STENCIL制作激光切割是可以再重工的方法;
44. 目前计算机主板上常用的BGA球径为0.76mm;
45. ABS系统为绝对坐标;
46. 陶瓷芯片电容ECA-0105Y-K31误差为±10%;
47. 目前使用的计算机的PCB, 其材质为: 玻纤板;
48. SMT零件包装其卷带式盘直径为13寸、7寸;
49. SMT一般钢板开孔要比PCB PAD小4um可以防止锡球不良之现象;
50. 按照《PCBA检验规范》当二面角>90度时表示锡膏与波焊体无附着性;
51. IC拆包后湿度显示卡上湿度在大于30%的情况下表示IC受潮且吸湿;
52. 锡膏成份中锡粉与助焊剂的重量比和体积比正确的是
90%:10% ,50%:50%;
53. 早期之表面粘装技术源自于20世纪60年代中期之军用及航空电子领域;
54. 目前SMT最常使用的焊锡膏Sn和Pb的含量各为: 63Sn 37Pb;
55. 常见的带宽为8mm的纸带料盘送料间距为4mm;
56. 在20世纪70年代早期,业界中新出现一种SMD, 为“密封式无脚芯片载体”, 常以LCC简代之;
57. 符号为272之组件的阻值应为2.7K欧姆;
58. 100NF组件的容值与0.10uf相同;
59. 63Sn 37Pb之共晶点为183℃;
60. SMT使用量最大的电子零件材质是陶瓷;
61. 回焊炉温度曲线其曲线最高温度215C最适宜;
62. 锡炉检验时,锡炉的温度245℃较合适;
63. 钢板的开孔型式方形、三角形、圆形,星形,本磊形;
64. SMT段排阻有无方向性无;
65. 目前市面上售之锡膏,实际只有4小时的粘性时间;
66. SMT设备一般使用之额定气压为5KG/cm2;
67. SMT零件维修的工具有:烙铁、热风拔取器、吸锡枪、镊子;
68. QC分为:IQC、IPQC、.FQC、OQC;
69. 高速贴片机可贴装电阻、电容、 IC、晶体管;
70. 静电的特点:小电流、受湿度影响较大;
71. 正面PTH, 反面SMT过锡炉时使用何种焊接方式扰流双波焊;
72. SMT常见之检验方法: 目视检验、X光检验、机器视觉检验
73. 铬铁修理零件热传导方式为传导 对流;
74. 目前BGA材料其锡球的主要成份Sn90 Pb10, SAC305,SAC405;
75. 钢板的制作方法雷射切割、电铸法、化学蚀刻;
76. 迥焊炉的温度按: 利用测温器量出适用之温度;
77. 迥焊炉之SMT半成品于出口时其焊接状况是零件固定于PCB上;
78. 现代质量管理发展的历程TQC-TQA-TQM;
79. ICT测试是针床测试;
80. ICT之测试能测电子零件采用静态测试;
81. 焊锡特性是融点比其它金属低、物理性能满足焊接条件、低温时流动性比其它金属好;
82. 迥焊炉零件更换制程条件变更要重新测量测度曲线;
83. 西门子80F/S属于较电子式控制传动;
84. 锡膏测厚仪是利用Laser光测: 锡膏度、锡膏厚度、锡膏印出之宽度;
85. SMT零件供料方式有振动式供料器、盘状供料器、卷带式供料器;
86. SMT设备运用哪些机构: 凸轮机构、边杆机构、螺杆机构、滑动机构;
87. 目检段若无法确认则需依照何项作业BOM、厂商确认、样品板;
88. 若零件包装方式为12w8P, 则计数器Pinth尺寸须调整每次进8mm;
89. 迥焊机的种类: 热风式迥焊炉、氮气迥焊炉、laser迥焊炉、红外线迥焊炉;
90. SMT零件样品试作可采用的方法:流线式生产、手印机器贴装、手印手贴装;
91. 常用的MARK形状有:圆形,“十”字形、正方形,菱形,三角形,万字形;
92. SMT段因Reflow Profile设置不当, 可能造成零件微裂的是预热区、冷却区;
93. SMT段零件两端受热不均匀易造成:空焊、偏位、墓碑;
94. 高速机与泛用机的Cycle time应尽量均衡;
95. 品质的真意就是第一次就做好;
96. 贴片机应先贴小零件,后贴大零件;
97. BIOS是一种基本输入输出系统,全英文为:Base Input/Output System;
98. SMT零件依据零件脚有无可分为LEAD与LEADLESS两种;
99. 常见的自动放置机有三种基本型态, 接续式放置型, 连续式放置型和大量移送式放置机;
100. SMT制程中没有LOADER也可以生产;
101. SMT流程是送板系统-锡膏印刷机-高速机-泛用机-迥流焊-收板机; 102. 温湿度敏感零件开封时, 湿度卡圆圈内显示颜色为蓝色,零件方可使用;
103. 尺寸规格20mm不是料带的宽度;
104. 制程中因印刷不良造成短路的原因:a. 锡膏金属含量不够,造成塌陷b.钢板开孔过大,造成锡量过多c. 钢板品质不佳,下锡不良,换激光切割模板d.Stencil背面残有锡膏,降低刮刀压力,采用适当的VACCUM和SOLVENT
105.一般回焊炉Profile各区的主要工程目的:a.预热区;工程目的:锡膏中容剂挥发。b.均温区;工程目的:助焊剂活化,去除氧化物;蒸发多余水份。c.回焊区;工程目的:焊锡熔融。d.冷却区;工程目的:合金焊点形成,零件脚与焊盘接为一体;
106. SMT制程中,锡珠产生的主要原因:PCB PAD设计不良、钢板开孔设计不良、置件深度或置件压力过大、Profile曲线上升斜率过大,锡膏坍塌、锡膏粘度过低。
SMT 之 IMC
简介
IMC系Intermetallic compound 之缩写,笔者将之译为"介面合金共化物"。广义上说是指某些金属相互紧密接触之介面间,会产生一种原子迁移互动的行为,组成一层类似合金的"化合物",并可写出分子式。在焊接领域的狭义上是指铜锡、金锡、镍锡及银锡之间的共化物。其中尤以铜锡间之良性Cu6Sn5(Eta Phase)及恶性Cu3Sn(Epsilon Phase)最为常见,对焊锡性及焊点可靠度(即焊点强度)两者影响最大,特整理多篇论文之精华以诠释之
定义
能够被锡铅合金焊料(或称焊锡Solder)所焊接的金属,如铜、镍、金、银等,其焊锡与被焊盘金属之间,在高温中会快速形成一薄层类似"锡合金"的化合物。此物起源于锡原子及被焊金属原子之相互结合、渗入、迁移、及扩散等动作,而在冷却固化之后立即出现一层薄薄的"共化物",且事后还会逐渐成长增厚。此类物质其老化程度受到锡原子与底金属原子互相渗入的多少,而又可分出好几道层次来。这种由焊锡与其被焊金属介面之间所形成的各种共合物,统称Intermetallic Compound 简称IMC,本文中仅讨论含锡的IMC,将不深入涉及其他的IMC。
一般性质
由于IMC曾是一种可以写出分子式的"准化合物",故其性质与原来的金属已大不相同,对整体焊点强度也有不同程度的影响,首先将其特性简述于下:
◎ IMC在PCB高温焊接或锡铅重熔(即熔锡板或喷锡)时才会发生,有一定的组成及晶体结构,且其生长速度与温度成正比,常温中较慢。一直到出现全铅的阻绝层(Barrier)才会停止(见图六)。
◎ IMC本身具有不良的脆性,将会损及焊点之机械强度及寿命,其中尤其对抗劳强度(Fatigue Strength)危害最烈,且其熔点也较金属要高。 ◎ 由于焊锡在介面附近得锡原子会逐渐移走,而与被焊金属组成IMC,使得该处的锡量减少,相对的使得铅量之比例增加,以致使焊点展性增大(Ductillity)及固着强度降低,久之甚至带来整个焊锡体的松弛。
◎ 一旦焊垫商原有的熔锡层或喷锡层,其与底铜之间已出现"较厚"间距过小的IMC后,对该焊垫以后再续作焊接时会有很大的妨碍;也就是在焊锡性(Solderability)或沾锡性(Wettability)上都将会出现劣化的情形。 ◎ 焊点中由于锡铜结晶或锡银结晶的渗入,使得该焊锡本身的硬度也随之增加,久之会有脆化的麻烦。
◎ IMC会随时老化而逐渐增厚,通常其已长成的厚度,与时间大约形成抛物线的关系,即:
δ=k √t,
k=k exp(-Q/RT)
δ表示t时间后IMC已成长的厚度。
K表示在某一温度下IMC
的生长常数。
T表示绝对温度。
R表示气体常数,
即8.32 J/mole。
Q表示IMC生长的活化能。
K=IMC对时间的生长常数,
以nm / √秒或μm / √日(
1μm / √日=3.4nm / √秒。
现将四种常见含锡的IMC在不同温度下,其生长速度比较在下表的数字中:
表1 各种IMC在不同温度中之生长速度(nm / √s)
金属介面 20℃ 100℃ 135℃ 150℃ 170℃
1. 锡 / 金 40
2. 锡 / 银 0.08 17-35
3. 锡 / 镍 0.08 1 5
4. 锡 / 铜 0.26 1.4 3.8 10
[注] 在170℃高温中铜面上,各种含锡合金IMC层的生长速率,也有所不同;如热浸锡铅为
5nm/s,雾状纯锡镀层为7.7(以下单位相同),锡铅比30/70的皮膜为11.2,锡铅比70/30的皮膜为12.0,光泽镀纯锡为3.7,其中以最后之光泽镀锡情况较好。
焊锡性与表面能
若纯就可被焊接之金属而言,影响其焊锡性(Solderability)好坏的机理作用甚多,其中要点之一就是"表面自由能"(Surface Free Energy,简称时可省掉Free)的大小。也就是说可焊与否将取决于:
(1) 被焊底金属表面之表面能(Surface Energy),
(2) 焊锡焊料本身的"表面能"等二者而定。
凡底金属之表面能大于焊锡本身之表面能时,则其沾锡性会非常好,反之则沾锡性会变差。也就是说当底金属之表面能减掉焊锡表面能而得到负值时,将出现缩锡(Dewetting),负值愈大则焊锡愈差,甚至造成不沾锡(Non-Wetting)的恶劣地步。
新鲜的铜面在真空中测到的"表面能"约为1265达因/公分,63/37的焊锡加热到共熔点(Eutectic Point 183℃)并在助焊剂的协助下,其表面能只得380达因/公分,若将二者焊一起时,其沾锡性将非常良好。然而若将上述新鲜洁净的铜面刻意放在空气中经历2小时后,其表面能将会遽降到25达因/公分,与380相减不但是负值(-355),而且相去甚远,焊锡自然不会好。因此必须要靠强力的助焊剂除去铜面的氧化物,使之再活化及表面能之再次提高,并超过焊锡本身的表面能时,焊锡性才会有良好的成绩。 锡铜介面合金共化物的生成与老化
当熔融态的焊锡落在洁铜面的瞬间,将会立即发生沾锡(Wetting俗称吃锡)的焊接动作。此时也立即会有锡原子扩散(Diffuse)到铜层中去,而铜原子也同时会扩散进入焊锡中,二者在交接口上形成良性且必须者Cu6Sn5的IMC,称为η-phase(读做Eta相),此种新生"准化合物"中含锡之重量比约占60%。若以少量的铜面与多量焊锡遭遇时,只需3-5秒钟其IMC即可成长到平衡状态的原度,如240℃的0.5μm到340℃的0.9μm。然而在此交会互熔的同时,底铜也会有一部份熔进液锡的主体锡池中,形成负面的污染。 (a) 最初状态:当焊锡着落在清洁的铜面上将立即有η-phase Cu6Sn5生成,即图中之(2)部分。
(b) 锡份渗耗期:焊锡层中的锡份会不断的流失而渗向IMC去组新的Cu6Sn5,而同时铜份也会逐渐渗向原有的η-phase层次中而去组成新的
Cu3Sn,即图中之(5)。此时焊锡中之锡量将减少,使得铅量在比例上有所增加,若于其外表欲再行焊接时将会发生缩锡。
(c) 多铅之阻绝层:当焊锡层中的锡份不断渗走再去组成更厚的IMC时,逐渐使得本身的含铅比例增加,最后终于在全铅层的挡路下阻绝了锡份的渗移。
(d) IMC的曝露:由于锡份的流失,造成焊锡层的松散不堪而露出IMC底层,而终致到达不沾锡的下场(Non-wetting)。
高温作业后经长时老化的过程中,在Eta-phase良性IMC与铜底材之间,又会因铜量的不断渗入Cu6Sn5中,而逐渐使其局部组成改变为Cu3Sn的恶性ε-phase(又读做Epsilon相)。其中铜量将由早先η-phase的40%增加到ε-phase的66%。此种老化劣化之现象,随着时间之延长及温度之上升而加剧,且温度的影响尤其强烈。由前述"表面能"的观点可看出,这种含铜量甚高的恶性ε-phase,其表面能的数字极低,只有良性η-phase的一半。因而Cu3Sn是一种对焊锡性颇有妨碍的IMC。
然而早先出现的良性η-phase Cu6Sn5, 却是良好焊锡性必须的条件。没有这种良性Eta相的存在,就根本不可能完成良好的沾锡,也无法正确的焊牢。换言之,必需要在铜面上首先生成Eta-phase的IMC,其焊点才有强度。否则焊锡只是在附着的状态下暂时冷却固化在铜面上而已,这种焊点就如同大树没有根一样,毫无强度可言。锡铜合金的两种IMC在物理结构上也不相同。其中恶性的ε-phase(Cu3Sn)常呈现柱状结晶(Columnar
Structure),而良性的η-phase(Cu6Sn5)却是一种球状组织(Globular)。下图8此为一铜箔上的焊锡经长时间老化后,再将其弯折磨平抛光以及微蚀后,这在SEM2500倍下所摄得的微切片实像,两IMC的组织皆清晰可见,二者之硬度皆在500微硬度单位左右。
在IMC的增厚过程中,其结晶粒子(Grains)也会随时在变化。由于粒度的变化变形,使得在切片画面中量测厚度也变得比较困难。一般切片到达最后抛光完成后,可使用专门的微蚀液(NaOH
50/gl,加1,2-Nitrphenol 35ml/l,70℃下操作),并在超声波协助下,使其能咬出清晰的IMC层次,而看到各层结晶解里面的多种情况。现将锡铜合金的两种IMC性质比较如下:
两种锡铜合金IMC的比较
命名 分子式 含锡量W% 出现经过 位置所在 颜色 结晶 性能 表面能η-phase(Eta) Cu6Sn5 60% 高温融锡沾焊到清洁铜面时立即生成 介于焊锡或纯锡与铜之间的介面
白色 球状
组织
良性IMC
微焊接强度之必须甚高
ε-phase(Epsilon) Cu3Sn 30% 焊后经高温或长期老化而逐渐发生 介于Cu6Sn5与铜面之间
灰色 柱状
结晶
恶性IMC
将造成缩锡或不沾锡 较低只有Eta的一半,非常有趣的是,单纯Cu6Sn5的良性IMC,虽然分子是完全相同,但当生长环境不同时外观却极大的差异。如将清洁铜面热浸于熔融态的纯锡中,此种锡量与热量均极度充足下,所生成的Eta良性IMC之表面呈鹅卵石状。但若改成锡铅合金(63/37)之锡膏与热风再铜面上熔焊时,亦即锡量与热量不太充足之环境,居然长出另一种一短棒状的IMC外表(注意铜与铅是不会产生IMC的,且两者之对沾锡(wetting)与散锡(Spreading)的表现也截然不同。再者铜锡之IMC层一旦遭到氧化时,就会变成一种非常顽强的皮膜,即使薄到5层原子厚度的1.5nm,再猛的助焊剂也都奈何不了它。这就是为什么PTH孔口锡薄处不易吃锡的原因(C.Lea的名著A scientific Guide to SMT之P.337有极清楚的说明),故知焊点之主体焊锡层必须稍厚时,才能尽量保证焊锡性于不坠。事实上当"沾锡"(Wetting)之初,液锡以很小的接触角(Contact Angle)高温中迅速向外扩张(Spreading)地盘的同时,也另在地盘内的液锡和固铜之间产生交流,而向下扎根生成IMC,热力学方式之步骤,即在说明其假想动作的细节。 锡铜IMC的老化
由上述可知锡铜之间最先所形成的良性η-phase(Cu6Sn5),已成为良好焊接的必要条件。唯有这IMC的存在才会出现强度好的焊点。并且也清楚了解这种良好的IMC还会因铜的不断侵入而逐渐劣化,逐渐变为不良的
ε-phase(Cu3Sn)。此两种IMC所构成的总厚度将因温度上升而加速长厚,且与时俱增。下表3.即为各种状况下所测得的IMC总厚度。凡其总IMC厚度愈厚者,对以后再进行焊接时之焊锡性也愈差。
表3. 不铜温度中锡铜IMC之不同厚度
所处状况 IMC厚度(mils)
熔锡板(指炸油或IR) 0.03~0.04
喷锡板 0.02~0.037
170℃中烤24小时 0.22以上
125℃中烤24小时 0.046
70℃中烤24小时 0.017
70℃中存贮40天 0.05
30℃中存贮2年 0.05
20℃中存贮5年 0.05
组装之单次焊接后 0.01~0.02
图12. 锡铜IMC的老化增厚,除与时间的平方根成比例关系外,并受到环境温度的强烈影响,在斜率上有很大的改变。
在IMC老化过程中,原来锡铅层中的锡份不断的输出,用与底材铜共组成合金共化物,因而使得原来镀锡铅或喷锡铅层中的锡份逐渐减少,进而造成铅份在比例上的不断增加。一旦当IMC的总厚度成长到达整个锡铅层的一半时,其含锡量也将由原来的60%而降到40%,此时其沾锡性的恶化当然就不言而喻。并由底材铜份的无限量供应,但表层皮膜中的锡量却愈来愈少,因而愈往后来所形成的IMC,将愈趋向恶性的Cu3Sn。
且请务必注意,一旦环境超过60℃时,即使新生成的Cu6Sn5也开始转变长出Cu3Sn来。 一旦这种不良的ε-phase成了气候,则焊点主体中之锡不断往介面溜走,致使整个主体皮膜中的铅量比例增加,后续的焊接将会呈现缩锡(Dewetting)的场面。这种不归路的恶化情形,又将随着原始锡铅皮膜层的厚薄而有所不同,越薄者还会受到空气中氧气的助虐,使得劣化情形越快。故为了免遭此一额外的苦难,一般规范都要求锡铅皮膜层至少都要在0.3mil以上。
老化后的锡铅皮膜,除了不良的IMC及表面能太低,而导致缩锡的效应外,镀铜层中的杂质如氧化物、有机光泽剂等共镀物,以及锡铅镀层中有机物或其它杂质等,也都会朝向IMC处移动集中,而使得缩锡现象雪上加霜更形恶化。
从许多种前人的试验及报告文献中,可知有三种加速老化的模式,可以类比出上述两种焊锡性劣化及缩锡现象的试验如下∶
◎ 在高温饱和水蒸气中曝置1~24小时。
◎ 在125~150℃的干烤箱中放置4~16小时。
◎ 在高温水蒸气加氧气的环境中放置1小时;之后仅在水蒸气中放置24小时;再另于155℃的干烤箱中放置4小时;及在40℃,90~95%RH环境中放置10天。如此之连续折腾
约等于1年时间的自然老化。 在经此等高温高湿的老化条件下,锡铅皮膜表面及与铜之介面上会出现氧化、腐蚀,及锡原子耗失(Depletion)等,皆将造成焊锡性的劣化。
锡金IMC
焊锡与金层之间的IMC生长比铜锡合金快了很多,由先后出现的顺序所得的分子式有AuSn
,AuSn2,AuSn4等。在150℃中老化300小时后,其IMC居然可增长到50μm(或2mil)之厚。因而镀金零件脚经过焊锡之后,其焊点将因IMC的生成太快,而变的强度减弱脆性增大。幸好仍被大量柔软的焊锡所包围,故内中缺点尚不曝露出来。又若当金层很薄时,例如是把薄金层镀在铜面上再去焊锡,则其焊点强度也很快就会变差,其劣化程度可由耐疲劳强度试验周期数之减少而清楚得知。
曾有人故意以热压打线法(Thermo-Compression,注意所用温度需低于锡铅之熔点)将金线压入焊锡中,于是黄金就开始向四周的焊锡中扩散,逐渐形成如图中白色散开的IMC。该金线原来的直径为45μm,经155℃中老化460小时后,竟然完全消耗殆尽,其效应实在相当惊人。但若将金层镀在镍面上,或在焊锡中故意加入少许的铟,即可大大减缓这种黄金扩散速度达5倍之多。
锡银IMC
锡与银也会迅速的形成介面合金共化物Ag3Sn,使得许多镀银的零件脚在焊锡之后,很快就会发生
银份流失而进入焊锡之中,使得银脚焊点的结构强度迅速恶化,特称为"渗银Silver leaching"。此种焊后可靠性的问题,曾在许多以钯层及银层
为导体的“厚膜技术"(Thick Film Technology)中发生过,SMT中也不乏前例。若另将锡铅共融合金比例63/37的焊锡成分,予以小幅的改变而加入2%的银,使成为62/36/2的比例时,即可减轻或避免发生此一"渗银"现象,其焊点不牢的烦恼也可为之舒缓。最近兴起的铜垫浸银处理(Immersion
Silver),其有机银层极薄仅4-6μm而已,故在焊接的瞬间,银很快就熔入焊锡主体中,最后焊点构成之IMC层仍为铜锡的Cu6Sn5,故知银层的功用只是在保护铜面而不被氧化而已,与有机护铜剂(OSP)之Enetk极为类似,实际上银本身并未参加焊接。
锡镍IMC
电子零件之接脚为了机械强度起见,常用黄铜代替纯铜当成底材。但因黄铜中含有多量的锌,对于焊锡性会有很大的妨碍,故必须先行镀镍当成屏障(Barrier)层,才能完成焊接的任务。事实上这只是在焊接的瞬间,先暂时达到消灾避祸的目的而已。因不久后镍与锡之间仍也会出现IMC,对焊点强度还是有不良的影响。
表4. 各种IMC在扩散系数与活化能方面的比较
System Intermetallic Compounds Diffusion Coefficient(m2/s) Activation Energy(J/mol)
Cu-Sn Cu6Sn5,Cu3Sn 1×106 80,000
Ni-Sn Ni3Sn2,Ni3Sn4,Ni3Sn7 2×107 68,000
Au-Sn AuSn,AuSn2 AuSn 3×104 73,000
Fe-Sn FeSnFeSn2 2×109 62,000
Ag-Sn Ag3Sn 8×109 64,000
在一般常温下锡与镍所生成的IMC,其生长速度与锡铜IMC相差很有限。但在高温下却比锡铜合金要慢了很多,故可当成铜与锡或金之间的阻隔层(Barrier Layer)。而且当环境温度不同时,其IMC的外观及组成也各不相同。此种具脆性的IMC接近镍面者之分子视为Ni3Sn4,接近锡面者则甚为分歧难以找出通式,一般以NiSn3为代表。根据一些实验数据,后者生长的速度约为前者的三倍。又因镍在空气非常容易钝化(Passivation),对焊锡性也会出现极其不利的影响,故一般在镍外表还要镀一层纯锡,以提高焊锡性。若做为接触(Contact)导电用途时,则也可镀金或银。
结论
各种待焊表面其焊锡性的劣化,以及焊点强度的减弱,都是一种自然现象。正如同有情世界的生老病死及无情世界的颓蚀风化一样均迟早发生,无法避免。了解发生的原因与过程之后,若可找出改善之道以延长其使用年限,即为上上之策矣。
SMT贴片红胶基本知识及应用指南
SMT贴片红胶基本知识及应用指南
关于SMT贴片红胶:SMT贴片红胶是一种聚稀化合物,与锡膏不同的是其受热后便固化,其凝固点温度为150℃,这时,红胶开始由膏状体直接变成固体。
SMT贴片红胶的性质
SMT贴片红胶具有粘度流动性,温度特性,润湿特性等。根据红胶的这个特性,故在生产中,利用红胶的目的就是使零件牢固地粘贴于PCB表面,防止其掉落。
SMT贴片红胶的应用
于印刷机或点胶机上使用 1、为保持贴片胶的品质,请置于冰箱内冷藏(5±3℃)储存 2、从冰箱中取出使用前,应放在室温下回温2~3小时 3、可以使用甲苯或醋酸乙酯来清洗胶管 点胶: 1、在点胶管中加入后塞,可以获得更稳定的点胶量 2、推荐的点胶温度为30-35℃ 3、分装点胶管时,请使用专用胶水分装机进行分装,以防止在胶水中混入气泡 刮胶:推荐的刮胶温度为30-35℃ 注意事项:红胶从冷藏环境中移出后,到达室温前不可打开使用。为避免污染原装产品,不得将任何使用过的贴片胶倒回原包装内。 SMT贴片红胶的工艺方式
1) 印刷方式:钢网刻孔要根据零件的类型,基材的性能来决定,其厚度和孔的大小及形状。其优点是速度快、效率高。 2) 点胶方式:点胶是利用压缩空气,将红胶透过专用点胶头点到基板上,胶点的大小、多少、由时间、压力管直径等参数来控制,点胶机具有灵活的功能。对于不同的零件,我们可以使用不同的点胶头,设定参数来改变,也可以改变胶点的形状和数量,以求达到效果,优点是方便、灵活、稳定。缺点是易有拉丝和气泡等。我们可以对作业参数、速度、时间、气压、温度调整,来尽量减少这些缺点。
3) 针转方式,是将一个特制的针膜,浸入浅胶盘中每个针头有一个胶点,当胶点接触基板时,就会脱离针头,胶量可以借着针的形状和直径大小来变化。固化温度 100℃ 120℃ 150℃ 固化时间 5分钟 150秒 60秒 典型固化条件:注意点:1、固化温度越高以及固化时间越长,粘接强度也越强。 2、由于贴片胶的温度会随着基板零件的大小和贴装位置的不同而变化,因此我们建议找出最合适的硬化条件。红胶的储存:在室温下可储存7天,在小于5℃时储存大于个6月,在5~25℃可储存大于30天。
SMT贴片红胶的管理
由于SMT贴片红胶受温度影响用本身粘度,流动性,润湿等特性,所以SMT贴片红胶要有一定的使用条件和规范的管理。1) 红胶要有特定流水编号,根据进料数量、日期、种类来编号。2) 红胶要放在2~8℃的冰箱中保存,防止由于温度变化,影响特性。3) 红胶回温要求在室温下回温4小时,按先进先出的顺序使用。4) 对于点胶作业,胶管红胶要脱泡,对于一次性未用完的红胶应放回冰箱保存,旧胶与新胶不能混用。5) 要准确地填写回温
记录表,回温人及回温时间,使用者需确认回温OK后方可使用。通常,红胶不可使用过期的。
SMT组装工艺
SMT组装工艺与焊接前的每一工艺步骤密切相关,其中包括资金投入、 PCB设计、元件可焊性、组装操作、焊剂选择、温度/时间的控制、焊料及晶体结构等。
1 焊料
目前,波峰焊接最常用的焊料是共晶锡铅合金:锡63%;铅37%,应时刻掌握焊锡锅中的焊料温度,其温度应高于合金液体温度183℃,并使温度均匀。过去,250℃的焊锡锅温度被视为“标准”。
随着焊剂技术的革新,整个焊锡锅中的焊料温度的均匀性得到了控制,并增设了预热器,发展趋势是使用温度较低的焊锡锅。在230-240℃的范围内设置焊锡锅温度是很普遍的。 通常,组件没有均匀的热质量,要保证所有的焊点达到足够的温度,以便形成合格的焊点是必要的。重要的问题是要提供足够的热量,提高所有引线和焊盘的温度,从而确保焊料的流动性,湿润焊点的两面。焊料的温度较低就会降低对元件和基板的热冲击,有助于减少浮渣的形成,在较低的强度下,进行焊剂涂覆操作和焊剂化合物的共同作用下,可使波峰出口具有足够的焊剂,这样就可减少毛刺和焊球的产生。 焊锡锅中的焊料成份与时间有密切关系,即随着时间而变化,这样就导致了浮渣的形成,这就是要从焊接的组件上去除残余物和其它金属杂质的原因及在焊接工艺中锡损耗的原因。以上这些因素可降低焊料的流动性。在采购中,要规定的金属微量浮渣和焊料的锡含量的最高极限,在各个标准中,(如象IPC/J-STD-006都有明确的规定)。在焊接过程中,对焊料纯度的要求在ANSI/J-STD-001B标准中也有规定。除了对浮渣的限制外,对63%锡;37%铅合金中规定锡含量最低不得低于61.5%。 波峰焊接组件上的金和有机泳层铜浓度聚集比过去更快。这种聚集,加上明显的锡损耗,可使焊料丧失流动性,并产生焊接问题。外表粗糙、呈颗粒状的焊点常常是由于焊料中的浮渣所致。由于焊锡锅中的集聚的浮渣或组件自身固有的残余物暗淡、粗糙的粒状焊点也可能是锡含量低的征兆,不是局部的特种焊点,就是锡锅中锡损耗的结果。这种外观也可能是在凝固过程中,由于振动或冲击所造成的。 焊点的外观就能直接体现出工艺问题或材料问题。为保持焊料“满锅”状态和按照工艺控制方案对检查焊锡锅分析是很重要的。由于焊锡锅中有浮渣而“倒掉”焊锡锅中的焊剂,通常来说是不必要的,由于在常规的应用中要求往锡锅中添加焊料,使锡锅中的焊料始终是满的。在损耗锡的情况下,添加纯锡有助于保持所需的浓度。为了监控锡锅中的化合物,应进行常规分析。如果添加了锡,就应采样分析,以确保焊料成份比例正确。 浮渣过多又是一个令人棘手的问题。毫无疑问,焊锡锅中始终有浮渣存在,在大气中进行焊接时尤其是这样。使用“芯片波峰”这对焊接高密度组件很有帮助,由于暴露于大气的焊料表面太大,而使焊料氧化,所以会产生更多的浮渣。焊锡锅中焊料表面有了浮渣层的覆盖,氧化速度就放慢了。
在焊接中,由于锡锅中波峰的湍流和流动而会产生更多的浮渣。 推荐使用的常规方法是将浮渣撇去,要是经常进行撇削的话,就会产生更多的浮渣,而且耗用的焊料更多。浮渣还可能夹杂于波峰中,导致波峰的不稳定或湍流,因此要求对焊锡锅中的液体成份给予更多的维护。如果允许减少锡锅中焊料量的话,焊料表面的浮渣会进入泵中,这种现象很可能发生。有时,颗粒状焊点会夹杂浮渣。最初发现的浮渣,可能是由粗糙波峰所致,而且有可能堵塞泵。锡锅上应配备可调节的低容量焊料传感器和报警装置。 2 波峰
在波峰焊接工艺中,波峰是核心。可将预热的、涂有焊剂、无污物的金属通过传送带送到焊接工作站,接触具有一定温度的焊料,而后加热,这样焊剂就会产生化学反应,焊料合金通过波峰动力形成互连,这是最关键的一步。目前,常用的对称波峰被称为主波峰,设定泵速度、波峰高度、浸润深度、传送角度及传送速度,为达到良好的焊接特性提供全方位的条件。应该对数据进行适当的调整,在离开波峰的后面(出口端)就应使焊料运行降速,并慢慢地停止运行。PCB随着波峰运行最终要将焊料推至出口。在最挂的情况下,焊料的表面张力和最佳化的板的波峰运行,在组件和出口端的波峰之间可实现零相对运动。这一脱壳区域就是实现了去除板上的焊料。应提供充分的倾角,不产生桥接、毛刺、拉丝和焊球等缺陷。有时,波峰出口需具有热风流,以确保排除可能形成的桥接。在板的底部装上表面贴装元件后,有时,补偿焊剂或在后面形成的“苛刻的波峰”区域的气泡,而进行的波峰整平之前,使用湍流芯片波峰。湍流波峰的高竖直速度有助于保证焊料与引线或焊盘的接触。在整平的层流波峰后面的振动部分也可用来消除气泡,保证焊料实现满意的接触组件。 焊接工作站基本上应做到:高纯度焊料(按标准)、波峰温度(230~250℃)、接触波峰的总时间(3~5秒钟)、印制板浸入波峰中的深度(50~80%),实现平行的传送轨道和在波峰与轨道平行状态下锡锅中焊剂含量。
3 波峰焊接后的冷却
通常在波峰焊机的尾部增设冷却工作站。为的是限制铜锡金属间化合物形成焊点的趋势,另一个原因是加速组件的冷却,在焊料没有完全固化时,避免板子移位。快速冷却组件,以限制敏感元件暴露于高温下。然而,应考虑到侵蚀性冷却系统对元件和焊点的热冲击的危害性。 一个控制良好的“柔和稳定的”、强制气体冷却系统应不会损坏多数组件。使用这个系统的原因有两个:能够快速处理板,而不用手夹持,并且可保证组件温度比清洗溶液的温度低。人们所关心的是后一个原因,其可能是造成某些焊剂残渣起泡的原因。另一种现象是有时会出现与某些焊剂浮渣产生反应的现象,这样,使得残余物“清洗不掉”。 在保证焊接工作站设置的数据满足所有的机器、所有的设计、采用的所有材料及工艺材料条件和要求方面没有哪个定式能够达到这些要求。必须了解整个工艺过程中的每一步操作。 4 结论 总之,要获得最佳的焊接质量,满足用户的需求,必须控制焊接前、焊接中的每一工艺步骤,因为SMT的整个组装工艺的每一步骤都互相关联、互相作用,任一步有问题都会影内到整体的可靠性和质量。焊接操作也是如此,所以应严格
控制所有的参数、时间/温度、焊料量、焊剂成分及传送速度等等。对焊接中产生的缺陷,应及早查明起因,进行分析,采取相应的措施,将影响质量的各种缺陷消灭在萌芽状态之中。这样,才能保证生产出的产品都符合技术规范。
SMT常用知识简介
在IT行业的解释
同步多线程(Simultaneous Multi-Threading,SMT)是一种在一个CPU 的时钟周期内能够执行来自多个线程的指令的硬件多线程技术。本质上,同步多线程是一种将线程级并行处理(多CPU)转化为指令级并行处理(同一CPU)的方法。
同步多线程是单个物理处理器从多个硬件线程上下文同时分派指令的能力。同步多线程用于在商用环境中及为周期/指令(CPI)计数较高的工作负载创造性能优势。
处理器采用超标量结构,最适于以并行方式读取及运行指令。同步多线程使您可在同一处理器上同时调度两个应用程序,从而利用处理器的超标量结构性质。任何单个应用程序都不能完全使该处理器达到满负荷。当一个线程遇到较长等待时间事件时,同步多线程还允许另一线程中的指令使用所有执行单元。例如,当一个线程发生高速缓存不命中,另一个线程可以继续执行。同步多线程是 POWER5? 和 POWER6? 处理器的功能,可与共享处理器配合使用。
SMT 对于商业事务处理负载的性能优化可达30%。在更加注重系统的整体吞吐量而非单独线程的吞吐量时,SMT 是一个很好地选择。
但是并非所有的应用都能通过SMT 取得性能优化。那些性能受到执行单元限制的应用,或者那些耗尽所有处理器的内存带宽的应用,其性能都不会通过在同一个处理器上执行两个线程而得到提高。
尽管SMT 可以使系统识别到双倍于物理CPU数量的逻辑CPU(lcpu),但是这并不意味着系统拥有了两倍的CPU能力。
SMT技术允许内核在同一时间运行两个不同的进程,以此来压缩多任务处理时所需要的总时间。这么做有两个好处,其一是提高处理器的计算性能,减少用户得到结果所需的时间;其二就是更好的能效表现,利用更短的时间来完成任务,这就意味着在剩下的时间里节约更多的电能消耗。当然这么做有一个总前提--保证SMT不会重复HT所犯的错误,而提供这个担保的则是在酷睿微架构中表现非常出色的分支预测设计。
SMT技术并不能做到处理资源的翻倍效果。虽然利用SMT技术可以让4核心变为8核心处理器,但是并不能做到每个独立核心处理资源。从本质来说,SMT技术只是软件层面上,以充分利用处理器闲置的执行单位为目的。
