化学机械抛光中机械与化学作用机制的仿真研究
1.选题背景及其意义
化学机械抛光(CMP)技术是芯片制造中的关键技术,随着集成电路特征尺寸的减小,CMP技术的应用面临新的挑战,例如,大尺寸硅片表面的抛光要求具有0.1nm的表面粗糙度[1],这些都对CMP技术提出了更高要求。深入系统的研究CMP的去除机理更利于CMP技术的提高与完善,因此十分重要。
现有的抛光理论认为:化学机械抛光过程是磨粒对材料表面的机械作用与抛光液的化学作用共同作用的结果,抛光液的化学作用削弱了芯片表面原子/分子的键能,而磨粒的机械作用将表面弱化的氧化原子/分子去除。但是对于机械化学的协调作用至今未有清晰的解释。本文针对化学机械抛光中材料去除激励的研究现状及其存在的问题,综合运用分子动力学与量子力学的方法,对抛光液中颗粒与材料表面的接触形式,表面材料的去除方式,抛光液中氧化剂、络合剂、PH值调节剂与材料表面的化学反应机理等方面进行了研究,从原子/分子的层次揭示CMP过程的抛光机理。本研究的完成对于可以使我们对于CMP的微观去除机理有更加清晰的认识,为高效,精确控制CMP过程提供理论指导。本文的研究涉及纳米摩擦学,纳米接触力学,材料,表面化学和物理等多个学科领域,使学科交叉的前沿性研究课题。本论文的研究对于丰富纳米摩擦学,纳米接触力学,材料,表面化学和物理等学科理论,提高我国IC制造业的水平具有重要的科学价值和实际意义[2]。
2. 国内外研究动态
2.1 化学机械抛光材料去除机理模型
2.1.1 经验-半经验去除率公式模型
1927年,Preston[3]提出了第一个材料去除率模型,认为材料的去除率与抛光压力和工作速度呈线性关系。Preston方程如下:
 (1)
(1)
式中:MRR代表表面材料去除率,P0为抛光压力,V为工作速度,Kp为Preston系数。Preston公式仅仅反映了抛光压力与相对速度两个过程参数对抛光速率的影响,其它影响因素都包括在Preston系数中。在抛光过程中,抛光去除率与抛光压力与速度等不呈现单纯的线性关系,还与其它因素有关,因此后来的许多学者对Preston方程进行了修正。例如,Tseng[4],Shi[5],等人分别提出了非线性材料去除率模型:
 (2)
(2)
虽然研究者对上述公式使用简单,公式中的参数均通过具体的实验得到。但是上述模型仍然不能考虑CMP中其它关键参数,如:抛光垫,磨粒,氧化剂等对去除速率的影响,不能揭示CMP过程中的材料去除机理。
2.1.2 基于流体动力学原理的材料去除率模型
基于流体动力学理论的CMP去除速率模型认为:被抛光硅片和抛光垫非直接接触、作用载荷全由硅片和抛光垫之间的抛光液薄膜所承受的条件下建立的。基于流体动力学理论的CMP去除速率模型主要有Runnels and Eyman[6]模型,Srikanth Sundararajan[7]模型,Dipto G. Thakurta[8]模型等。可是这种观点无法解释抛光垫对材料去除的作用,更难以解释抛光液中磨粒的机械作用和抛光液的化学作用以及两者的协同作用对于CMP过程的巨大影响。后来的实验研究表明[9]:在没有磨粒的机械作用或者抛光液的化学作用时,芯片的抛光速度至少会降低一个数量级以上,并且Lin[10]的研究表明:CMP中材料表面流体压力很小,为接触压力的1/35左右,因此研究者认为流体的冲蚀磨损不是CMP中材料去除的主要方式。
2.1.3基于接触力学理论的材料去除率模型
基于接触力学理论,研究人员建立了不同的硅片、磨粒和抛光垫之间的接触模型来研究CMP中材料去除机理。基于连续介质的压痕-划痕材料去除机理,Luo等根据接触力学和统计理论提出了较为完善的材料去除模型,模型假设芯片/磨粒以及磨粒/抛光垫之间的接触变形为塑性变形,其模型接触示意图见图1所示。
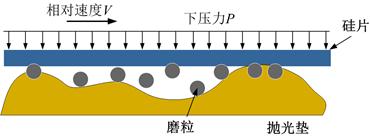
图1. 抛光材料-磨粒-抛光垫接触示意图
Luo[11, 12]模型中考虑了有效磨粒数、抛光垫特性、芯片特性和抛光工艺参数等因素的影响。得到材料的去除率模型为:
 (3)
(3)
其中,ρw为芯片材料的质量密度,Nr为有效磨粒数,Volremoved为单个磨粒的去除率,MRRCo为化学作用导致的材料去除率。但该模型并未能将MRRCo进行定量化。

图2. Zhao模型示意图
Zhao[13, 14]等人基于弹塑性接触力学和磨损原理建立了硅片CMP材料去除机理模型。该模型认为硅片与抛光垫之间的接触可以采用Greenwood and Williamson弹性模型来建立模型,模型的三个接触变量是:硅片表面和抛光垫表面之间的实际接触面积,抛光液中参与磨损过程的磨粒数量,磨粒嵌入硅片表面的深度。根据三个抛光变量,得到的CMP材料去除率MRR的近似公式为:
 (4)
(4)
上式中:At为抛光过程中硅片与抛光垫的实际接触面积;α2表示相对于基片化学成膜密度比率,V表示硅片和抛光垫之间的相对速度;A0为抛光垫和硅片的名义接触面积;δaW为磨粒嵌入硅片表面材料的深度;D为磨粒的平均直径,χ为抛光液中磨粒的体积浓度。
Zhao等人的模型较符合CMP的实际情况,通过其模型预测介质层的CMP去除率与实验结果符合很好。但是由于其对化学作用的考虑只是以一个系数的形式体现在去除率公式中,对化学和机械协同作用的研究不够。
在连续介质机理基础上,采用接触力学的方法,Fu[15],Che[16],Bastawors[17],Lin[10],Kuide[18]等人推导出了各自的CMP材料去除模型。这些模型虽然都反映了磨粒对材料去除的机械作用,但是还不能求出单个磨粒受到的力。而且这些模型都没有化学作用对材料去除的影响,无法解释抛光液的化学作用。
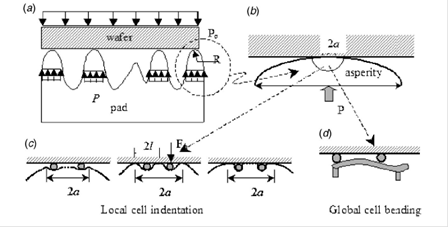
图3. Che的模型图
2.1.4 包含化学作用影响的材料去除率模型
Kaufman[19]认为化学作用在芯片表面形成一层氧化薄膜,而机械作用将该氧化薄膜去除,从而提出了CMP协调去除机理,如图4。以此机理为基础,众多学者展开了对CMP化学作用的研究。Chen[20]采用吸附与解吸附理论,建立了材料去除率模型,见图5,该模型定性解释了化学作用在CMP中的影响,但模型参数过多,进行定量计算困难。Christopher[21]应用化学动力学理论,提出了CMP过程中的五步去除机理,如图6所示:① 氧化剂从抛光液中传递到芯片表面;② 部分氧化剂吸附到芯片表面;③ 吸附的氧化剂和新鲜表面发生反应;④ 机械去除氧化产物;⑤ 去除材料进入抛光液被带走。
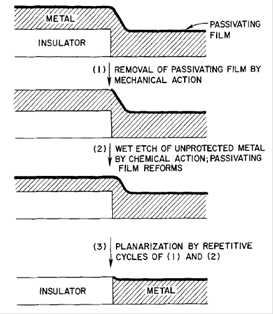
图4. Kaufman提出的化学机械协调作用模型
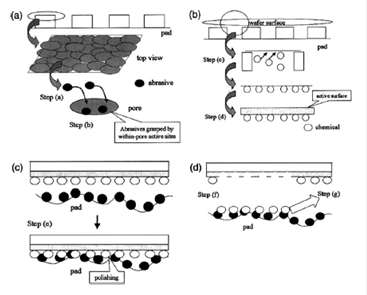
图5. Chen基于吸附解吸附理论的材料去除率模型

图6. Christopher CMP过程中的五步去除机理示意图
Jiang[21]等人研究CMP过程中芯片表面氧化薄膜生成去除机理,该模型分析了机械作用(工作压力,工作速度,磨粒浓度,磨粒的粒度分布)和化学作用(氧化剂种类、氧化剂浓度)对材料去除率的影响,但该模型的参数有待进一步通过实验加以确定。
2.2 化学机械抛光过程仿真研究现状
2.2.1 CMP中磨粒机械作用仿真研究

图7.基于EAM势的铜化学机械抛光的仿真模型(a) 完全化学溶解作用下 (b) 部分化学溶解作用下
Ye[22, 23] 等人利用EAM势模拟了机械作用与化学作用共同作用下的铜化学机械抛光过程(图7)。仿真表明,机械作用可以产生比较粗糙的加工表面,并在磨粒前面产生切屑,同时造成硅基体内部的位错。化学作用则可以产生比较光滑的表面,且使得磨粒和硅片之间的摩擦力减小,从而可以抑止硅基体内部的位错。
段芳莉[24, 25]等人利用Leonard-Jones势函数(LJ势)和Tersoff势函数模拟了LJ团簇冲击单晶硅基体的过程(图8),对团簇的反弹现象、基体的变形以及碰撞过程中基体势能和团簇运动轨迹的关系等进行了相关研究。

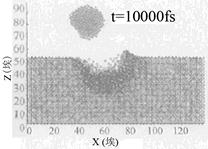
(a) (b)
图8 . LJ团簇冲击单晶硅基体的过程 (a) t=0fs (b) t=10000fs
陈入领[26, 27]采用分子动力学模拟方法研究二氧化硅团簇与硅基体之间在干、湿碰撞过程中的作用机制(见图9)。通过碰撞过程的仿真分析,揭示超精密表面加工中纳米颗粒的作用机理,从原子尺度进一步探索超精密表面加工技术的材料去除机理,为进一步提高超精密表面加工水平提供理论指导。
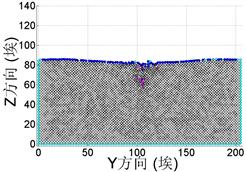

(a) (b)
图9. 5184-团簇在2500m/s和0°冲击后基体损伤图 (a)干碰撞 (b)湿碰撞
Chagarov[28]等人利用MD模拟了CMP中材料去除过程,分析了抛光速度和团簇的尺寸大小对去除材料的影响,见图10。这个模型模拟了CMP抛光硅片时,硅片被氧化为二氧化硅后材料去除过程,考虑了硅片表面的氧化层和二氧化硅的抛光粒子之间的作用,认为二氧化硅磨粒在碰撞过程中沉积在硅片表面,形成了相对平整的表面。

图10. 二氧化硅团簇划过氧化后的硅基体的过程
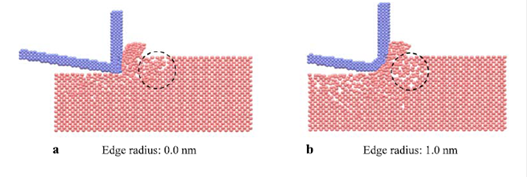
图11. Han模拟的不同颗粒半径的材料去除过程
Han[29, 30]等人研究了化学机械抛光过程中硅材料的材料去除机理,认为硅材料以塑性去除方式进行材料去除。材料的塑性去除方式导致了CMP后的光滑表面,见图11。
2.2.2 CMP过程中化学作用仿真研究
Yamauchi[31]等人通过第一性原理方法模拟了EEM中材料去除过程,研究表明,EEM确实存在通过二氧化硅团簇和硅表面的化学作用实现材料去除的可能性,见图12。

图12.第一性原理方法下的EEM中原子转移的仿真(a) 初始状态 (b) 氢键结合 (c) 硅烷形成 (d) 硅表面原子脱离
Rajendran[32]等人利用TBMD(Tight-Binding Molecular Dynamics Simulation, TBMD)分析了CeO2颗粒抛光SiO2表面的去除机理(图13),讨论了抛光过程中原子间键长和电荷的变化。但由于TBMD方法本身的局限性,和第一性原理方法一样,它们仿真的系综规模都很小,一般都在1000个粒子以下。

图13.CeO2颗粒对SiO2表面的CMP模拟
Yokosuka[33, 34]采用紧束缚势的方法研究了化学机械抛光过程中铜表面的氧化过程(见图14),此模拟采用双氧水作为抛光液。分别研究了溶液PH值和铜的miller平面对于铜氧化过程的影响。研究结果发现:抛光液的PH值显著影响铜的氧化过程,同时铜的氧化过程与铜的miller平面密切相关。

图14 .Yokosuka 研究的三种系统:(a)铜(100)面,水与双氧水比值13:1;(b)铜(100)面,水与双氧水比值13:4;(c)铜(111)面,水与双氧水比值13:4
在常见的工艺参数下,根据接触理论分析的到的芯片表面磨粒的压入深度接近0.1nm。对于这类处于原子,分子状态的材料去除特征,用连续介质力学来描述不是十分合适。Zhao等人提出了非连续介质力学来描述不合适,现在多采用原子/分子去除机理来建模。
综上所述,随着磨粒直径的减小,CMP材料原子/分子去除机理的研究将日趋合理。目前基于原子/分子的去除机理模型的研究还处于刚刚起步的阶段,研究很少,而且现有的研究还处于定性研究,无法准确定量预测CMP的材料去除率。而且化学作用对材料去除机理的研究还有待深入。从上述的讨论我们总结出现在CMP研究的两个大的趋势。一方面,目前的CMP研究多是从原子/分子量级的去除机理出发进行研究,由于颗粒在材料中的压入深度在亚纳米量级,我们进行了分子动力学的研究,发现在此压入深度下,材料的去除呈现单分子层的去除,得到的表面没有划痕等缺陷与实际过程十分符合。基于此我们提出了单分子层的去除机理。另一方面,现在越来越多的学者认识到CMP过程的去除是化学作用与机械作用结合的作用,因此多注重化学与机械协同作用的研究。因此寻求化学与机械作用协同作用处理方法变得日益重要。
参考文献
1. 王永光. 基于分子量级的化学机械抛光材料去除机理的理论与实验研究[博士学位论文]. 无锡:江南大学,2008.
2. 王永光, 赵永武. 基于分子量级的化学机械抛光材料去除机理. 半导体学报, 2007,28(2):308-312.
3. Preston F, The theory and design of plate glass polishing machines. Journal of the Society of Glass Technology, 1927, 11: 214-256.
4. Tseng W T, Wang Y L. Re-examination of Pressure and Speed Dependences of Removal Rate during Chemical-Mechanical Polishing Processes. Journal of The Electrochemical Society, 1997, 144(2): L15-L17.
5. Shi F G, Zhao B. Modeling of chemical-mechanical polishing with soft pads. Applied Physics A: Materials Science & Processing, 1998, 67(2): 249-252.
6. Runnels S R, Eyman L M. Tribology Analysis of Chemical-Mechanical Polishing. Journal of The Electrochemical Society, 1994, 141(6): 1698-1701.
7. Sundararajan S, et al. Two-Dimensional Wafer-Scale Chemical Mechanical Planarization Models Based on Lubrication Theory and Mass Transport. Journal of The Electrochemical Society, 1999, 146(2): 761-766.
8. Thakurta D G, et al. Three-Dimensional Chemical Mechanical Planarization Slurry Flow Model Based on Lubrication Theory. Journal of The Electrochemical Society, 2001, 148(4): 207-214.
9. Larsen B J, Liang H. Probable role of abrasion in chemo-mechanical polishing of tungsten. Wear, 1999, 233-235: 647-654.
10. Lin J F, et al. Analysis of the Tribological Mechanisms Arising in the Chemical Mechanical Polishing of Copper-Film Wafers. Journal of Tribology, 2004, 126(1): 185-199.
11. Luo J B, Dornfeld D A. Material removal mechanism in chemical mechanical polishing: theory and modeling. IEEE Transactions on Semiconductor Manufacturing, 2001, 14(2): 112-133.
12. Luo J B, Dornfeld D A. Material removal regions in chemical mechanical planarization for submicron integrated circuit fabrication: coupling effects of slurry chemicals, abrasive size distribution, and wafer-pad contact area. IEEE Transactions on Semiconductor Manufacturing, 2003. 16(1): 45-56.
13. Zhao, Y, Chang L. A micro-contact and wear model for chemical-mechanical polishing of silicon wafers. Wear, 2002, 252(3-4): 220-226.
14. Zhao, Y, Chang L. S.H. Kim. A mathematical model for chemical-mechanical polishing based on formation and removal of weakly bonded molecular species. Wear, 2003, 254(3-4): 332-339.
15. Fu G, et al. A plasticity-based model of material removal in chemical-mechanical polishing (CMP). IEEE Transactions on Semiconductor Manufacturing, 2001, 14(4):406-417.
16. Che W, et al. A Scratch Intersection Model of Material Removal During Chemical Mechanical Planarization (CMP). Journal of Manufacturing Science and Engineering, 2005, 127(3): 545-554.
17. Bastawros A, et al. Pad effects on material-removal rate in chemical-mechanical planarization. Journal of Electronic Materials, 2002, 31(10): 1022-1031.
18. Qin K, Moudgil B, Park C. A chemical mechanical polishing model incorporating both the chemical and mechanical effects. Thin Solid Films, 2004, 446(2): 277-286.
19. Kaufman F B, et al. Chemical-Mechanical Polishing for Fabricating Patterned W Metal Features as Chip Interconnects. Journal of The Electrochemical Society, 1991, 138(11): 3460-3465.
20. Chen P H, et al. Catalytic-Pad Chemical Kinetics Model of CMP. Electrochemical and Solid-State Letters, 2003, 6(12): 140-142.
21. Borst C L, et al. Surface Kinetics Model for SiLK Chemical Mechanical Polishing. Journal of The Electrochemical Society, 2002, 149(2): 118-127.
22. Ye Y Y, Biswas R, Morris J R. Molecular dynamics simulation of nanoscale machining of copper. Nanotechnology, 2003, 14(3):390-396.
23. Ye Y Y, Biswas R, Morris J R. Simulation of chemical mechanical planarization of copper with molecular dynamics. Applied Physics Letters, 2002, 81(10):1875-1877.
24. 段芳莉. 纳米颗粒碰撞下的单晶硅表面原子形态. 科学通报, 2005, 50(13):1417-1421.
25. 段芳莉. 纳米粒子与单晶硅表面碰撞的反弹机理研究. 物理学报, 2005, 54(6):2832-2837.
26. Chen R L, et al. Extrusion formation mechanism on silicon surface under the silica cluster impact studied by molecular dynamics simulation. Journal of Applied Physics, 2008, 104(10): 104907-6.
27. Chen R L, et al. Energy transfer under impact load studied by molecular dynamics simulation. Journal of Nanoparticle Research, 2009, 11(3): 589-600.
28. Evgueni C, James B A. Molecular dynamics simulations of mechanical deformation of amorphous silicon dioxide during chemical mechanical polishing. Journal of Applied Physics, 2003. 94(6):3853-3861.
29. Han X S, Study micromechanism of surface planarization in the polishing technology using numerical simulation method. Applied Surface Science, 2007, 253(14): 6211-6216.
30. Han X S, Hu Y Z. Investigation of material removal mechanism of silicon wafer in the chemical mechanical polishing process using molecular dynamics simulation method. Applied Physics A: Materials Science & Processing, 2009, 95(3): 899-905.
31. Yamauchi K, et al. First-principles simulations of removal process in EEM (Elastic Emission Machining). Computational Materials Science, 1999, 14(1-4): 232-235.
32. Rajendran A, et al. Tight-binding quantum chemical molecular dynamics simulation of mechano-chemical reactions during chemical-mechanical polishing process of SiO2 surface by CeO2 particle. Applied Surface Science, 2005. 244(1-4): 34-38.
33. Yokosuka T, Sasata K, Kurokawa H. Quantum Chemical Molecular Dynamics Studies on the Chemical Mechanical Polishing Process of Cu Surface. Japanese Journal of Applied Physics, 2003, 42(4): 1897-1902.
34. Yokosuka T, Kurokawa H. Development of new tight-binding molecular dynamics program to simulate chemical-mechanical polishing processes. Japanese journal of applied physics, 2002, 41(4): 2410-2413.
3.课题研究内容
1) 抛光颗粒对材料去除的机械作用仿真研究
a. 考察被抛光表面实现原子级光滑的原因,利用纳米切屑的方式模拟颗粒对材料表面的加工。重点考虑颗粒的压入深度、颗粒与材料之间相对速度,颗粒的大小对于实现原子级光滑的影响。
b. 考虑在纳米切削过程中材料内的温度、压力、相变等变化,以及这些变化对于材料去除造成的影响。
c. 研究在化学机械抛光过程中颗粒与被抛光表面的摩擦学特性。包括摩擦力的变化,摩擦系数,材料磨损方式等。
d. 研究磨粒与材料之间作用与磨粒与化学作用产物之间作用,进行相互对比,借此发现化学作用在CMP中起到的作用,对于机械作用的影响等。
e. 利用AFM模拟单个颗粒对被抛光材料表面的作用,为仿真数据提供参照。
2) 抛光液对材料去除的化学作用仿真研究
a. 采用Dmol3软件模块模拟双氧水等氧化剂对于铜表面的氧化作用机理。
b. 采用Dmol3软件模块模拟BTA等缓蚀剂对于铜表面的缓蚀作用机理。
c. 采用Dmol3软件模块模拟络合剂对于铜表面的络合作用机理。
d. 研究络合剂,氧化剂,缓蚀剂共同存在时,与铜表面的相互作用机理。
4. 研究方案
本课题拟采取的技术路线如图15所示:
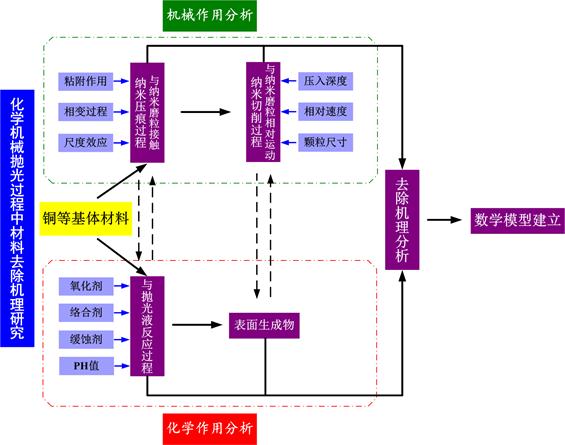
图15 . 技术路线示意图
5. 工作特色及难点
本课题的工作特色为:
本课题针对现有的认为磨粒在材料中压入深度为0.1nm量级的研究,采用分子动力学模拟的方法研究了在0.1nm压入深度下材料去除机理,提出了单原子层去除机理,很好的揭示了CMP实现高精度表面的原因;利用Dmol3软件模拟CMP过程中化学反应作用,揭示缓蚀剂,氧化剂,络合剂存在时的化学反应原理。对于机械作用与化学作用的协同作用机理进行系统研究。
本课题的研究难点在于:
a. 缓蚀剂,氧化剂,络合剂与铜表面化学反应的模拟。
b. 缓蚀剂,氧化剂,络合剂共同存在时与铜表面化学反应先后机理揭示。
c. 采用何种方法研究化学作用与机械作用的协同作用。
6. 预期成果和可能的创新点
a. 采用分子动力学模拟的方法研究了在0.1nm压入深度下材料去除机理,提出了单原子层去除机理,很好的揭示了CMP实现高精度表面的原因;
b. 首次系统模拟CMP过程中化学反应作用,揭示缓蚀剂,氧化剂,络合剂存在时的化学反应原理。
c. 对于机械作用与化学作用的协同作用机理进行系统研究。可以更好的指导工业实践。
d. 在SCI主流期刊上发表论文2-3篇。
7. 论文工作的总体安排
20##年9月到20##年12月,文献调研及科研背景调查学习;CMP过程机械作用的分子动力学模拟,单分子层去除机理的提出。
20##年12月到20##年12月,拟CMP过程中化学反应作用,揭示缓蚀剂,氧化剂,络合剂存在时的化学反应原理。对于机械作用与化学作用的协同作用机理进行系统研究。
20##年1月到20##年7月,实验结果的总结、理论分析和建模,论文撰写。
