曹飞 个人版总结
引言
第一只晶体管
?第一只晶体管, AT&T Bell Lab, 1947
?第一片单晶锗, 1952
?第一片单晶硅, 1954 (25mm,1英寸)
?第一只集成电路(IC), TI, 1958
?第一只IC商品, Fairchild, 1961
摩尔定律晶体管最小尺寸的极限
?价格保持不变的情况下晶体管数每12月翻一番,1980s后下降为每18月翻一番;
?最小特征尺寸每3年减小70%
?价格每2年下降50%;
IC的极限
?硅原子直径: 2.35 Å;
?形成一个器件至少需要20个原子;
?估计晶体管最小尺寸极限大约为50 Å或0.005um,或5nm。
电子级多晶硅的纯度
一般要求含si>99.9999以上,提高纯度达到99.9999999—99.999999999%(9-11个9)。其导电性介于10-4-1010 。电子级高纯多晶硅以9N以上为宜。
。电子级高纯多晶硅以9N以上为宜。
1980s以前半导体行业的模式
1980s以前:大多数半导体公司自己设计、制造和测试IC芯片,如
Intel,IBM
1990s以后半导体行业的模式
F&F模式,即Foundry(代工)+Fabless(无生产线芯片设计),
什么是Foundry
有晶圆生产线,但没有设计部门;接受客户订单,为客户制造芯片;
IC流程图:
接受设计订单→芯片设计→EDA编辑版图→将版图交给掩膜版制造商→制造晶圆→芯片测试→芯片封装
硅片制备与高温工艺
单晶生长:直拉法区熔法
高温工艺:氧化,扩散,退火。
Si集成电路芯片元素组成
■半导体(衬底与有源区):单晶Si
■杂质(N型和P型):P (As)、B
■导体(电极及引线):Al、Wu(Cu 、Ti)、poly-Si
■绝缘体(栅介质、多层互连介质):SiO2、Si3N4
硅的重要性
■储量丰富,便宜;(27.6%)
■SiO2性质很稳定、良好介质,易于热氧化生长;
■较大的禁带宽度(1.12eV),较宽工作温度范围
硅提纯 I的工艺步骤、化学反应式及纯度
从石英砂到硅锭
■石英砂(SiO2)→冶金级硅(MGS)
■HCl与MGS粉反应形成TCS■(trichlorosilane:氯硅烷)
■利用汽化和冷凝提纯TCS
■TCS与H2反应形成多晶硅(EGS)
■熔融EGS和拉单晶硅锭
从硅锭到硅片
单晶硅锭→整型→切片→磨片倒角→刻蚀→抛光→清洗→检查→包装
化学反应式

硅提纯I
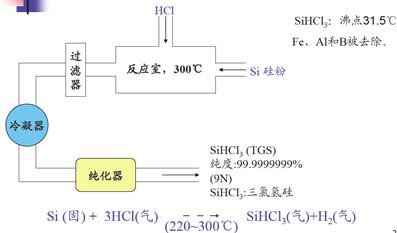
多晶硅淀积

直拉法的拉晶过程
拉晶过程
①熔硅②引晶(下种)③收颈④放肩
直拉法的拉晶过程中收颈的作用
目的:抑制位错从籽晶向晶体延伸
直拉法与区熔法的对比
直拉法,更为常用(占75%以上)
⑴便宜⑵更大的圆片尺寸(300mm已生产)⑶剩余原材料可重复使用⑷位错密度:0~104cm2
区熔法
⑴高纯度的硅单晶(不使用坩锅)(电阻率20##Ω-mm)⑵成本高,可生产圆片尺寸较小(150mm)⑶主要用于功率器件⑷位错密度:103~105cm2
定位边或定位槽的作用
①识别晶向、导电类型及划片方向 ②硅片(晶锭)机械加工定位的参考面;
③硅片装架的接触位置
外延的定义:外延、外延层、外延片、同质外延、异质外延
外延层:单晶衬底上单晶薄膜层
外延:同质外延和异质外延
同质外延:衬底与外延层为相同晶体,晶格完全匹配
异质外延:衬底与外延层为不同晶体,晶格不匹配
双极晶体管(电路)和CMOS器件(电路)中外延层的应用
双极晶体管(电路)中外延层的应用
■高阻的外延层可提高集电结的击穿电压
■低阻的衬底(或埋层)可降低集电极的串联电阻
CMOS器件(电路)中外延层的应用
■ 减小pnpn寄生闸流管效应降低漏电流
Si外延的源材料
■Si源气体:SiH4(硅烷), SiH2Cl2(二氯硅烷),
SiHCl3(三氯硅烷), SiCl4(四氯硅烷)
■ 掺杂剂
N型掺杂剂:PH3, AsH3
P型掺杂剂:B2H6
分子束外延(MBE)的特点
高温工艺设备小结
■高温工艺通常使用炉管反应室;
■反应炉通常由控制系统、气体输运系统、反应腔、装卸片系统和尾气处理系统构成
■立式炉管使用最广泛,因为其占地面积小、污染控制好、维护量小
■温度控制的精确性和均匀性对于高温工艺的成功至关重要
氧化膜在IC中的应用
■掺杂阻挡层■表面钝化(保护)?■隔离层■栅氧化层■MOS电容的介质材料
各种氧化层在工艺中的应用、厚度及工艺
掺杂阻挡氧化层应用
■Much lower B and P diffusion rates in SiO2than that in S
■SiO2can be used as diffusion mask
表面钝化(保护)氧化层应用
■Pad Oxide衬垫(缓冲)氧化层, Screen Oxide屏蔽氧化层
Sacrificial Oxide牺牲氧化层, Barrier Oxide阻挡氧化层
■Normally thin oxide layer (~150Å) to protect silicon defects from contamination and over-stress
器件隔离氧化层应用
■Electronic isolation of neighboring devices
■Blanket field oxide
■Local oxidation of silicon (LOCOS)
■Thick oxide, usually 3,000 to 10,000 Å
栅氧化层应用
■Gate oxide: thinnest and most critical layer
■Capacitor dielectric
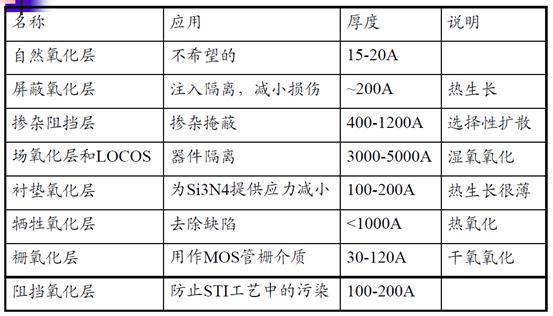
1号液和2号液的配方及作用
■SC-1-NH4OH:H2O2:H2O with 1:1:5 to 1:2:7 ratio at 70 to 80℃to remove organic contaminants.(1号液)
■SC-2--HCl:H2O2:H2Owith 1:1:6 to 1:2:8 ratio at 70 to 80 ℃to remove inorganic contaminates.(2号液)
颗粒、有机粘污、无机粘污及本征氧化层的清洗
Pre-oxidation(预氧化) Wafer Clean Organic(有机)Removal
■Strong oxidants remove organic residues
■H2SO4:H2O2or NH3OH:H2O2followed by DI H2O rinse.
■ High pressure scrub or immersion in heated dunk tank followed by rinse, spin dry and/or dry bake (100 to 125 °C).
Pre-oxidation Wafer Clean Inorganic(无机)Removal
■HCl:H2O
■Immersion (浸入)in dunk tank followed by rinse, spin dry and/or dry bake (100 to 125℃)
Pre-oxidation Wafer Clean Native Oxide Removal(本征氧化层)
■HF:H2O
■Immersion(浸入)in dunk tank or single wafer vapor etcher followed by rinse, spin dry and/or dry bake (100 to 125℃)
SiO2生长的迪尔-格罗夫模型
干氧氧化和湿氧氧化的特点与应用
干(氧)氧化
■氧化剂:干燥的O2■Si+O2→SiO2■O来源于提供的氧气;Si来源于衬底硅圆片■O2通过表面已有的氧化层向内扩散并与Si反应生长SiO2■氧化膜越厚,生长速率越低■干氧化速率最低
湿(氧)氧化
■氧化剂:O2携带H2O■Si+O2→SiO2■Si+ 2H2O →SiO2+ 2H2
■湿氧化的生长速率介于水汽氧化与干氧化之间■实际氧化工艺:干氧+湿氧+干氧
氧化工艺应用
干氧化,薄氧化层(<1000A)
-■MOS栅氧化层(30~120A)-■衬垫氧化层(100~200A),--■屏蔽氧化层(~200A),■牺牲氧化层(<1000A),等等
湿氧化,厚氧化层
■场氧化层(3000~5000A)■扩散掩膜氧化层(400~1200A)
掺氯氧化的作用
■Cl 可以减少氧化层中的可动离子(如Na+)■MOS栅极氧化中广泛采用
■氧化速率提高(1~5)%
影响氧化速率的因素
■温度■湿氧化或干氧化■厚度■压力■硅片晶向(<100>或<111>)■硅中杂质
氧化速率与温度
■氧化速率对温度很敏感,指数规律■温度升高会引起更大的氧化速率升高
氧化速率与圆片晶向
■<111>表面的氧化速率高于<100>表面■原因:<111>表面的Si原子密度高
氧化速率与杂质浓度
■掺杂浓度越高,氧化层生长速率越高
Si-SiO2界面特性替位式扩散、间隙式扩散、扩散系数
在Si-SiO2界面有四种不同类型的电荷:(1)可动离子电荷(2)氧化层固定电荷(3)界面陷阱电荷(4)氧化层陷阱电荷
杂质再硅晶体中的主要扩散机构有:间隙式扩散、替位式扩散。
替位式扩散:杂质从一个晶格位置运动到另一个晶格位置上称为替位式扩散
间隙式扩散:杂质从一个间隙位置到另一个间隙位置上的运动称为间隙式扩散
两步扩散工艺
两步法扩散分预淀积和再分布两步进行,第一步称为预扩散或预淀积,在较低的温度下,采用恒定表面浓度扩散方式在硅片便面扩散一薄层杂质原子,目的在于确定进入硅片的杂质总量。第二步称为主扩散或再分布或推进扩散,在较高的温度下,采用很定杂质总量扩散方式,让淀积在表面的杂质继续往硅片中扩散,目的在于控制扩散深度和表面浓度。
扩散的局限性与应用
扩散技术的主要缺陷
■扩散是各向同性的,掩膜下方也会有杂质横向扩散
■不能独立控制结深和掺杂浓度
扩散应用
■主要用在阱注入后的推进工艺
离子注入后为什么要退火
■高能离子损伤晶体结构■非晶硅有很高的电阻率
■需要外部能量如热使其恢复单晶结构■只有在单晶结构中杂质才能被激活
RTP(快速热退火)的优点
■快速升温(75 to 150 °C/sec)■更高温度(up to 1200 °C)
■过程快速■使杂质扩散最小化■热预算的更好控制(节约能源)
■更好的圆片间均匀性控制
薄膜淀积
真空蒸发法蒸发源加热方式
■电阻加热■电子束加热■激光加热■高频感应加热
溅射的工作原理与特点
原理;具有一定能量的入射离子对固体表面轰击时,入射离子与固体表面原子碰撞发生能量和动量的转移,将固体表面的原子溅射出来
直流溅射特点:只适于金属靶材。
磁控溅射特点:淀积速率最高。
RF溅射特点:适于各种金属与非金属靶材。
PVD 与 CVD对比
■CVD:衬底表面发生化学反应
■PVD:衬底表面不发生化学反应
■CVD: 更好的台阶覆盖性(50% to ~100%) 和空隙填充能力
■PVD: 台阶覆盖性差(~ 15%) 和空隙填充能力差
■PVD 源: 固态材料
■CVD 源: 气体或蒸汽
CVD氧化硅与热生长氧化硅对比
■热生长氧化硅
?O来源于气源,Si来源于衬底?氧化物生长消耗硅衬底?高质量
■CVD 氧化硅
?O和Si都来自气态源?淀积在衬底表面?生长温度低(如PECVD)?生长速率高
CVD介质薄膜的应用
■浅槽隔离(STI):undopedsilicon dioxide glass, USG■侧墙隔离:USG
■金属前介质(PMD):PSG or BPSG■金属层间介质(IMD/ILD):USG or FSG■钝化介质(PD):Oxide/Nitride
CVD的基本过程
① 传输②吸附③化学反应④淀积⑤脱吸⑥逸出
CVD生长的两种极限:表面反应控制与质量输运(传输)控制
表面反应控制型
■化学反应速率不能满足反应剂扩散和吸附的速率,反应剂堆积在衬底表面等待反应;■淀积速率=反应速率■淀积速率对温度很敏感
质量输运控制型
■表面化学反应速率足够高,当反应剂被吸附在衬底表面时会立即反应■淀积速率=D dn/dx■淀积速率对温度不敏感■淀积速率主要受到气体流速的控制
CVD 的三种类型及各自的应用
■APCVD 常压化学气相淀积■LPCVD 低压化学气相淀积
■PECVD 等离子体增强化学气相淀积
CVD淀积速率G与温度T的关系
■低温下,hg>>ks,反应控制过程,故G与T呈指数关系;
■高温下,hg<<ks,质量输运控制过程,hg对T不敏感,故G趋于平稳。
离子注入
离子注入与热扩散的对比

离子注入的两种阻挡机制
核碰撞和电子碰撞
避免沟道效应的方法
■倾斜硅片, 7°最常用■屏蔽氧化层(无定形)■注入前预先无定型处理
离子注入机的原理

离子注入工艺的应用及技术趋势
离子注入工艺
■CMOS工艺应用■CMOS离子注入的工艺要求■离子注入工艺的评价。
技术趋势
■超浅结(USJ)■绝缘体上硅(SOI)■等离子体沉浸离子注入(PIII)
SOI的优势
■芯片速度更快,耗电更少■电路密度提高
■SOI尤其在RF与SoC方面表现出色
SOI圆片的制造:智能剥离与注氧隔离
离子注入特点:
⑴注入温度低⑵掺杂数目受控⑶横向扩散小⑷不受固溶度限制⑸注入深度随离子能量增加而增加⑹适合化合物掺杂
光刻与刻蚀工艺(曝光、刻蚀)
光刻的需要及光刻三要素
■高分辨率■光刻胶高光敏性■精确对准
正胶与负胶的比较

光刻工艺的10个步骤
(1)硅片清洗 (2)预烘和底膜涂覆(3)涂光刻胶(4)前烘(5)对准(6)曝光(7)后烘(8)显影(9)坚膜(10)图形检测
前烘、后烘及坚膜工艺目的(作用)的比较
前烘作用: 促进胶膜内溶剂充分挥发,使胶膜干燥;
增加胶膜与SiO2 (Al膜等)的粘附性及耐磨性
后烘作用:平衡驻波效应,提高分辨率。
坚膜的作用
■蒸发PR中所有有机溶剂■提高刻蚀和注入的抵抗力■提高光刻胶和表面的黏附性■聚合和使得PR更加稳定■PR流动填充针孔
4种曝光机
■接触式曝光机■接近式曝光机■投影式曝光机■步进式曝光机
分辨率与波长及NA的关系
(最小线宽)R由曝光系统的光波长λ和数值孔径NA决定,R=K1λ/NA
K1为系统常数, λ光波长, NA = 2r0/D;
■NA: 凸镜收集衍射光的能力
如何提高分辨率?
■提高NA
更大的凸镜, 可能很昂贵而不实际
减小DOF(焦深),会引起制造困难
■减小光波长
开发新光源, PR和设备
波长减小的极限:UV到DUV, 到EUV, 到X-Ray
■减小K1
相移掩膜
移相掩模的原理与应用
移相掩模是一种双层设计结构,通过利用干涉技术抵消某些衍射效应,可使光刻分辨率的改进达到25%~100%
两种紫外线和三种深紫外线的名称、波长及对应的最小特征尺寸
■汞灯i-line, 365 nm:–常用在0.35 μm光刻
■DUV KrF受激准分子激光器, 248 nm:应用0.25 μm, 0.18 μm and 0.13 μm光刻
■ArF受激准分子激光器,193 nm:–应用: < 0.13 μm
■F2受激准分子激光器:157 nm:–仍处于研发阶段, < 0.10 μm应用
■157 nm F2激光器光刻:使用相移掩膜, 即使0.035 μm 都是可以的
下一代光刻
■超紫外■X射线■电子束
干法刻蚀与湿法刻蚀的对比
湿法刻蚀的优点
■高选择性■设备成本较低■批处理, 高产量
湿法刻蚀的缺点
■各向同性■不能刻蚀3μm以下图形■化学品使用量高■化学品危险
干法刻蚀优点:
■各向异性腐蚀强;■分辨率高;■刻蚀3μm以下线条

湿法刻蚀SiO2、Si、Poly-Si及Si3N4的配方及反应式
湿法刻蚀SiO2
常用配方(KPR胶):HF: NH4F: H2O=3ml:6g:10ml
(HF溶液浓度为48%)
SiO2+ 6HF →H2SiF6 + 2H2O
湿法刻蚀Si、Poly-Si
HNO3-HF-H2O(HAC)混合液

湿法刻蚀Silicon Nitride
热(150 to 200 °C) 磷酸H3PO4溶液

干法刻蚀的原理与种类
① 等离子体刻蚀:化学性刻蚀②溅射刻蚀:纯物理刻蚀③反应离子刻蚀(RIE):结合①、②
干法刻蚀SiO2、Si、Poly-Si及Si3N4的腐蚀剂
刻蚀气体:CF4 、BCl3、CCl4、CHCl3、SF6
金属化与多层互连
金属化的应用、三种最常用的金属及三种不同的金属化方法
应用
■栅电极材料■金半接触电极材料■互连材料
常用的金属性材料
■掺杂的poly-Si■金属硅化物■金属合金
金属化方法
多晶硅-重掺杂,LPCVD淀积
金属硅化物-淀积
合金=淀积(PVD,CVD)
集成电路对金属化的基本要求
1. 形成低阻欧姆接触;2. 提供低阻互连线;3. 抗电迁移;4. 良好的附着性;5. 耐腐蚀;6. 易于淀积和刻蚀;7. 易键合;8. 层与层之间绝缘要好
90年代CMOS标准金属化:栅材料,接触孔(通孔)填充材料,阻挡层(势垒层)、黏附层、焊接层、及防反射层材料,互连材料,金半接触电极材料及工艺
Al-Si接触的尖楔现象、影响及抑制
Al/Si接触的尖楔现象:Si在Al中的溶解度及快速扩散
影响:PN结穿刺 –Al刺穿过掺杂PN结,使源/漏与衬底短路
抑制:400 ℃热退火在Si-Al界面形成Si-Al合金
Al的电迁移现象、影响及抑制
电迁移:大电流密度下发生质量(离子/晶粒)输运
现象:在阳极端堆积形成小丘或须晶,造成电极间短路;
在阴极端形成空洞,导致电极开路
影响;
■电迁移使金属线变窄变薄■残留引线中电流密度更高■电迁移影响IC的可靠性
电迁移抑制
■少量铜与铝形成的合金将大大提供Al对电迁移的抵抗,铜作为Al晶粒间的粘合剂,防止Al晶粒因电子轰击而迁移
■Al-Cu (0.5%) 最常用■使用Al-Si-Cu 合金
TiN的作用
TiN:阻挡层,防止W扩散
TiN:粘合层,帮助W与SiO2表面粘合在一起
TiN:防反射涂层ARC(Anti-reflection coating),防止反射提高光刻分辨率
Cu淀积的大马士革镶嵌工艺
① 在低K介质层上刻蚀出Cu互连线用的沟槽;
② ②CVD淀积一层薄的金属势垒层:防止Cu的扩散
③ ③溅射淀积Cu的籽晶层:电镀或化学镀Cu需要
④ ④沟槽和通孔淀积Cu:电镀或化学镀;
⑤400℃下退火;
⑤ Cu的CMP。
工艺集成
MOS IC与双极IC的隔离
MOS集成电路的隔离:LOCOS隔离工艺;侧墙掩蔽的隔离工艺;浅槽隔离等.
双极集成电路的隔离:pn结隔离工艺;深槽隔离工艺.
防止寄生场效应晶体管开启及提高寄生晶体管阈值电压的工艺方法
防止寄生场效应晶体管开启的方法
提高寄生场效应晶体管的阈值电压使寄生场效应晶体管的阈值电压高于集成电路的工作电压
4.提高寄生晶体管阈值电压的方法
1)、增加场区SiO2的厚度;(但是过厚的氧化层将产生过高的台阶,从而引起台阶覆盖的问题)
2)、增大氧化层下沟道的掺杂浓度,即形成沟道阻挡层
局部氧化(LOCOS)、侧墙掩蔽的隔离(SWAMI)及浅槽隔离(STI,Shallow Trench Isolation)工艺的特点、工艺流程及示意图
局部氧化工艺
优点: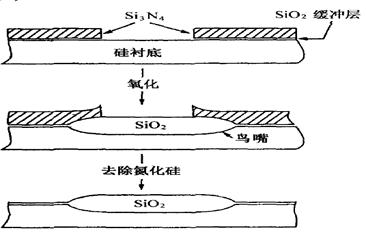
1.可以减小表面的台阶高度;2.和高浓度杂质注入是一次光刻完成的
缺点:
1、鸟嘴侵蚀有源区;2、不利于后序工艺中的平坦化;3、杂质重新分布。
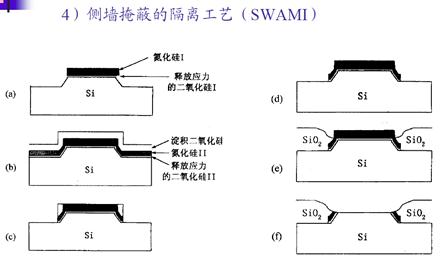

P阱、N阱工艺特点
P阱工艺:易实现nMOS和pMOS的性能匹配,适于静态逻辑电路
n阱工艺:易获得高性能的nMOS,适于微处理器、DRAM
熟悉双阱CMOS IC工艺流程
1)硅片准备2)阱的制备3)场区隔离:4)CMOS器件形成5)多层金属互联6)后部封装工艺
熟悉标准埋层双极集成电路工艺流程
标准埋层双极集成电路工艺流程
1)、衬底准备2)、埋层的制备3)、外延层生长4)、隔离区的形成(第二次光刻)5)、收集极接触的制备(第三次光刻)6)、基区的形成(第四次光刻)7)、发射区的形成(第五次光刻)8)、金属接触和互联(第六、七次光刻)9)、后续封装工艺
CMOS工艺流程
了解1960s、1970s和1980s集成电路工艺的特点



熟悉1990sCMOS工艺的特点:特征尺寸、衬底、隔离、光刻、刻蚀、退火、W塞及平整化
1990’s CMOS Technology
Photolithography
– G-line, I-line (365 nm), and DUV 248 nm
– Positive photoresist
– Steppers replaced projection printer
– Track-stepper integrated systems
? Plasma etches for patterned etch
? Wet etches for blanket film stripping
? Vertical furnaces
– smaller footprints, better contamination control.
? RTP systems
– post-implantation annealing
– silicide formation,
– faster, better process and thermal budget control.
? DC magnetron sputtering replaced evaporation ? Multi-layer metal interconnection
? W CVD and CMP (or etch back) to form plugs
? Ti and TiN barrier/adhesion layer for W
? Ti welding layer for Al-Cu to reduce contact
resistance
? TiN ARC ? BPSG was popularly used as PMD.
? DCVD: PE-TEOS and O3-TEOS
– STI, sidewall spacer, PMD, and IMD
? DCVD: PE-silane
– PMD barrier nitride, dielectric ARC, and PD nitride
? Tungsten CMP to form plug
? Dielectric CMP for planarization ? Cluster tools became very popular
? Single wafer processing systems improve
wafer-to-wafer uniformity control
? Batch systems is still commonly employed
in many non-critical processes for their high
throughput.
